VarMan:工艺偏差和良率分析
在使用新的半导体工艺技术进行设计时,必须仔细考虑硅晶圆之间和器件之间的工艺变化,以实现目标规格和生产良率。这可能需要进行数千、数百万甚至数十亿次蒙特卡罗仿真,因为某些器件如存储器中的位单元,可能需要进行 7 西格玛及以上的分析。
这时,传统的蒙特卡罗仿真速度就显得太慢了,尤其是在设计项目很紧急的情况下。VarMan 具有突破性的技术,与传统的蒙特卡罗仿真相比,其仿真性能提高了 30倍,同时具有相同的准确性。其高西格玛分析能力提供了非常快速和准确的良率预估,并能够快速识别样本故障和设计缺陷。
VarMan可轻松集成到设计流程中。它支持主流的第三方及专有的晶体管级仿真器,并具有直观、易于使用的界面。它提供真正的统计角提取和局部差异性分析,能够处理巨量的参数。
工艺偏差
VarMan提供7种针对模拟、单元库和存储器应用的统计分析:
快速蒙特卡罗分析:
- VarMan基于蒙特卡罗分析的创新方法提供了与经典蒙特卡罗分析相同的结果,而速度提高了30倍以上。

高西格玛性能限制:
- 在给定西格玛(良率)的情况下,这一方法将找到与此良率相对应的设计性能极限。这在仿真上非常经济,并且对多失效区域具有强大的鲁棒性。

高西格玛性能限制:
- 在给定设计性能极限的情况下,这一方法可通过少量仿真快速验证和预估4-6+西格玛的良率。
- 找出导致参数错误的工艺配置,以准确估算良率并预测小概率的事件。

高西格玛扩展(HSS):
- “高西格玛扩展”(HSS)一次生成一个完整的单元良率视图,从极低西格玛到高西格玛,以确保设计具有最佳的功耗、性能和面积。 HSS对非线性和非高斯分布具有较高的高鲁棒性,这在先进的工艺技术节点中较为适用。
偏差eXplorer分析:
- 根据用户控制的仿真次数限制,突显设计性能关键区域,并识别从3西格玛到高西格玛的边际性。
- 性价比很高,提供由差异引起的边际角和最有影响的参数。

真实角点提取:
- 为实现给定的良率,查找满足设计性能的统计角点 PVT 参数。与花费长时间验证数量巨大的PVT角点组合相比,此分析大大减少了设计中基本真实角点的仿真次数。

局部偏差分析:
- 高级灵敏度分析,帮助设计师识别对局部偏差敏感的热点。通过有限的仿真次数,VarMan 能够识别对局部偏差最敏感的晶体管。
优势
- 突破性的分析技术提供了令人印象深刻的仿真提速,显著节省了时间,结果的准确性也非常稳定。
- 可靠而经过验证的分析,在先进的FinFET和FDSOI工艺技术节点上得到验证。
- 支持所有主流的SPICE仿真器和设计环境。
- 用户友好的图形用户界面,通过对数据和波形的访问以及快速易用的“load and analyze”模型,清晰呈现结果。
- 智能仿真管理器,充分利用LSF/SGE/OGE/Slurm计算集群。
应用
- 模拟、射频、标准单元、IO 和存储器等


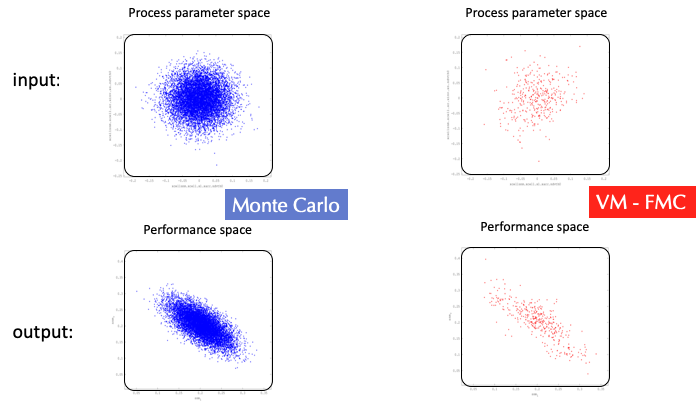




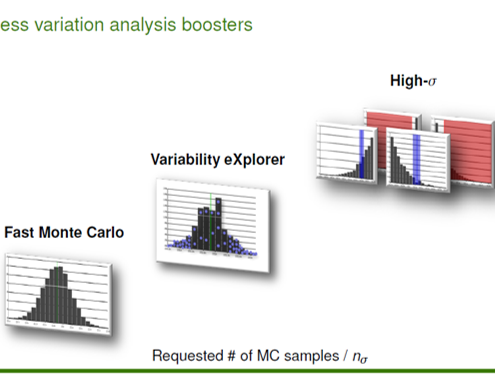
Machine Learning in the EDA-Specific Domain – 20 Years in the Making
Memory Statistical Characterization Solution with VarMan
Standard Cell Statistical Characterization with VarMan
Statistical Analysis Flow for Analog Design with VarMan
Variation aware design for advanced nodes and low power technologies